QR kode

Produkter
Kontakt os


Fax
+86-579-87223657

E-mail

Adresse
Wangda Road, Ziyang Street, Wuyi County, Jinhua City, Zhejiang-provinsen, Kina
Siliciumcarbid er et af de ideelle materialer til fremstilling af høje temperatur, højfrekvent, højeffekt og højspændingsenheder. For at forbedre produktionseffektiviteten og reducere omkostningerne er fremstillingen af siliciumcarbidunderlag i stor størrelse en vigtig udviklingsretning. Sigter mod procestravene for8-tommer siliciumcarbid (SIC) enkelt krystalvækst, Vækstmekanismen for Silicon Carbide Physical Vapor Transport (PVT) -metode blev analyseret, varmesystemet (TAC Guide Ring, TAC Coated Crucible,Tac coatede ringe, Tac coated plade, tac coated tre-petal ring, tac coated trepetal digel, tac coatet holder, porøs grafit, blød filt, stiv filt sic-coated krystalvækstsceptor og andenSIC Single Crystal Growth Process Reservedeleleveres af Vetek Semiconductor), digelrotation og procesparameterkontrolteknologi af siliciumcarbid-enkeltkrystallvækstovn blev undersøgt, og 8-tommer krystaller blev med succes fremstillet og dyrket gennem termisk feltsimuleringsanalyse og proceseksperimenter.
Indledning
Siliciumcarbid (SIC) er en typisk repræsentant for den tredje generation af halvledermaterialer. Det har ydelsesfordele såsom større båndgapbredde, det elektriske felt med højere sammenbrud og højere termisk ledningsevne. Det fungerer godt inden for høje temperatur, højtryk og højfrekvente felter og er blevet en af de vigtigste udviklingsretninger inden for halvledermaterialeteknologi. På nuværende tidspunkt bruger den industrielle vækst af siliciumcarbidkrystaller hovedsageligt fysisk damptransport (PVT), som involverer komplekse multi-fysiske feltkoblingsproblemer med multfase, multi-komponent, multiple varme og masseoverførsel og magneto-elektrisk varmestrømsinteraktion. Derfor er design af PVT -vækstsystemet vanskeligt, og procesparametermåling og kontrol underkrystalvækstproceser vanskeligt, hvilket resulterer i vanskeligheden med at kontrollere kvalitetsdefekterne af de dyrkede siliciumcarbidkrystaller og den lille krystalstørrelse, så omkostningerne ved anordninger med siliciumcarbid som underlag forbliver høje.
Silicium Carbide Manufacturing Equipment er grundlaget for siliciumcarbidteknologi og industriel udvikling. Det tekniske niveau, processevne og uafhængig garanti for siliciumcarbid-enkeltkrystallvækstovn er nøglen til udviklingen af siliciumcarbidmaterialer i retning af stor størrelse og højt udbytte, og er også de vigtigste faktorer, der driver tredje generation af halvlederindustrien til at udvikle sig i retning af lav omkostning og storskala. I halvlederindretninger med siliciumcarbid enkeltkrystall som substrat udgør værdien af substratet for den største andel, ca. 50%. Udviklingen af siliciumcarbidkrystallvækstudstyr i stor størrelse af stor størrelse, forbedring af udbyttet og vækstraten for siliciumcarbid-enkeltkrystallsubstrater og reduktion af produktionsomkostninger er af vigtig betydning for anvendelsen af relaterede enheder. For at øge produktionskapacitetsforsyningen og yderligere reducere de gennemsnitlige omkostninger ved siliciumcarbidenheder er det en af de vigtige måder at udvide størrelsen på siliciumcarbidunderlag en af de vigtige måder. På nuværende tidspunkt er den internationale mainstream siliciumcarbidsubstratstørrelse 6 tommer, og det er hurtigt gået frem til 8 inches.
De vigtigste teknologier, der skal løses i udviklingen af 8-tommer siliciumcarbid-enkeltkrystallvækstovne, inkluderer: (1) Design af stor størrelse termisk feltstruktur for at opnå en mindre radial temperaturgradient og en større langsgående temperaturgradient, der er egnet til vækst af 8-tommer siliciumcarbidkrystaller. ) (3) Automatisk kontrol af procesparametre under dynamiske forhold, der imødekommer behovene i højkvalitets enkelt krystalvækstproces.
1 PVT -krystalvækstmekanisme
PVT -metoden er at fremstille siliciumcarbid -enkeltkrystaller ved at placere SIC -kilden i bunden af en cylindrisk tæt grafit -digel, og Sic -frøkrystallen anbringes nær digeldækslet. Crucible opvarmes til 2 300 ~ 2 400 ℃ ved radiofrekvensinduktion eller resistens og er isoleret af grafitfelt ellerPorøs grafit. De vigtigste stoffer, der transporteres fra SIC -kilden til frøkrystallen, er Si, Si2C -molekyler og SiC2. Temperaturen ved frøkrystallen kontrolleres for at være lidt lavere end ved den nedre mikro-pulver, og en aksial temperaturgradient dannes i diglen. Som vist i figur 1 sublimeres siliciumcarbidmikro-pulver ved høj temperatur for at danne reaktionsgasser af forskellige gasfasekomponenter, der når frøkrystallen med en lavere temperatur under drevet af temperaturgradienten og krystalliseres på den for at danne en cylindrisk siliciumcarbidindgang.
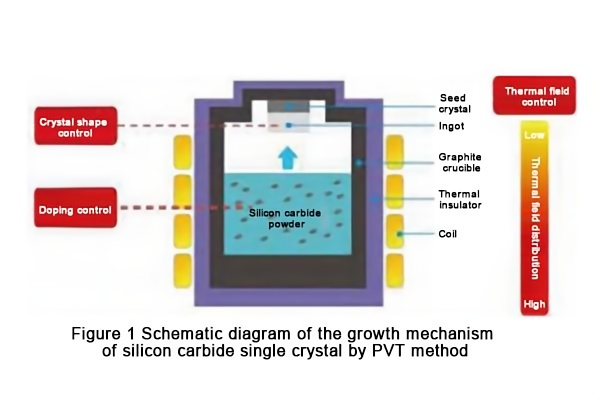
De vigtigste kemiske reaktioner af PVT -vækst er:
SIC (S) ⇌ SI (G)+C (S)
2sic ⇌ og2C (G)+C (S)
2SIC ⇌ SIC2 (G)+SI (L, G)
Sic (s) ⇌ sic (g)
Egenskaberne ved PVT -vækst af SIC -enkeltkrystaller er:
1) Der er to gas-faste grænseflader: den ene er gas-Sic-pulvergrænsefladen, og den anden er gas-krystalgrænsefladen.
2) Gasfasen er sammensat af to typer stoffer: den ene er de inerte molekyler, der indføres i systemet; den anden er gasfasekomponenten, der er produceret ved nedbrydning og sublimering afSic pulver. Gasfasekomponenterne simcn interagerer med hinanden, og en del af de såkaldte krystallinske gasfasekomponenter, der opfylder kravene i krystallisationsprocessen, vil vokse ind i SIC-krystallen.
3) In the solid silicon carbide powder, solid-phase reactions will occur between particles that have not sublimated, including some particles forming porous ceramic bodies through sintering, some particles forming grains with a certain particle size and crystallographic morphology through crystallization reactions, and some silicon carbide particles transforming into carbon-rich particles or carbon particles due to non-stoichiometric decomposition og sublimering.
4) Under krystalvækstprocessen vil der forekomme to faseændringer: den ene er, at de faste siliciumcarbidpulverpartikler omdannes til gasfasekomponenter, der ligger simcn gennem ikke-støkiometriske nedbrydning og sublimering, og den anden er, at gasfasekomponenternes simcn omdannes til gitterpartikler gennem krystallisation.
2 Udstyrsdesign
Som vist i figur 2 inkluderer siliciumcarbidens enkeltkrystallvækstovn hovedsageligt: øvre dækselmontering, kammerenhed, varmesystem, digelrotationsmekanisme, lavere dækningsløftningsmekanisme og elektrisk kontrolsystem.

2.1 Varmesystem
Som vist i figur 3 vedtager varmesystemet induktionsopvarmning og er sammensat af en induktionsspole, enGrafit Crucible, et isoleringslag (Stiv filt, Blød filt) osv. Når den mediumfrekvensskiftende strøm passerer gennem den multi-svinginduktionsspole, der omgiver ydersiden af grafit-diglen, vil der blive dannet et induceret magnetfelt med samme frekvens i grafit-diglen, hvilket genererer en induceret elektromotorisk kraft. Da grafitmaterialet med høj renhed har god ledningsevne, genereres en induceret strøm på digelvæggen, der danner en hvirvelstrøm. Under virkningen af Lorentz -styrken vil den inducerede strøm til sidst konvergere på den ydre væg af digelen (dvs. hudeffekten) og svækkes gradvist langs den radiale retning. På grund af eksistensen af hvirvelstrømme genereres joulevarme på den ydre væg af digelen og bliver opvarmningskilden til vækstsystemet. Størrelsen og fordelingen af joulevarme bestemmer direkte temperaturfeltet i diglen, hvilket igen påvirker væksten af krystallen.
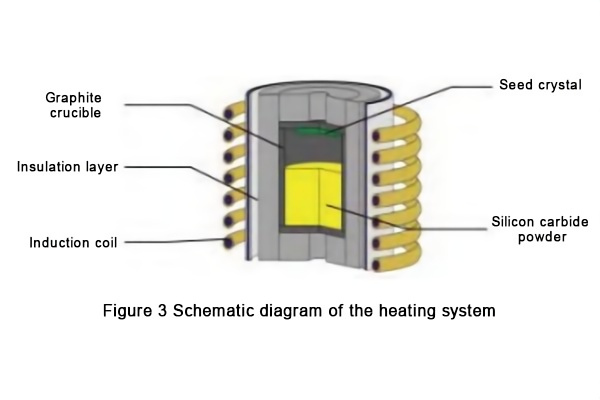
Som vist i figur 4 er induktionsspolen en vigtig del af varmesystemet. Den vedtager to sæt uafhængige spiralstrukturer og er udstyret med henholdsvis øvre og nedre præcisionsbevægelsesmekanismer. Det meste af det elektriske varmetab for hele varmesystemet bæres af spolen, og tvungen afkøling skal udføres. Spolen vikles med et kobberrør og afkøles af vand inde. Frekvensområdet for den inducerede strøm er 8 ~ 12 kHz. Hyppigheden af induktionsopvarmningen bestemmer penetrationsdybden af det elektromagnetiske felt i grafit -diglen. Spolebevægelsesmekanismen bruger en motordrevet skruepar-mekanisme. Induktionsspolen samarbejder med induktionseffektforsyningen for at opvarme den interne grafit -digel for at opnå sublimeringen af pulveret. På samme tid kontrolleres kraften og den relative placering af de to sæt spoler for at gøre temperaturen ved frøkrystallen lavere end ved den nedre mikropulver, hvilket danner en aksial temperaturgradient mellem frøkrigen og pulveret i diglen og danner en rimelig radial temperaturgradient ved siliciumkarbidkrystallen.

2.2 Crucible rotationsmekanisme
Under væksten af stor størrelsesiliciumcarbid enkeltkrystaller, Crucible i vakuummiljøet i hulrummet bliver fortsat roterende i henhold til proceskravene, og gradientens termiske felt og lavtrykstilstanden i hulrummet skal holdes stabilt. Som vist i figur 5 bruges et motordrevet gearpar til at opnå stabil rotation af digelen. En magnetisk væskeforseglingsstruktur bruges til at opnå dynamisk tætning af den roterende skaft. Den magnetiske væskeforsegling bruger et roterende magnetfeltkredsløb, der dannes mellem magneten, den magnetiske polsko og den magnetiske ærme til at adsorbere den magnetiske væske mellem polsko-spidsen og ærmet for at danne en O-ringlignende flydende ring, hvilket fuldstændigt blokerer for kløften for at opnå formålet med forsegling. Når den rotationsbevægelse overføres fra atmosfæren til vakuumkammeret, bruges den flydende O-ring dynamiske tætningsindretning til at overvinde ulemperne ved let slid og lavt liv i fast forsegling, og de to processer, der stopper for at stoppe alle kanaler, der kan lække luft, og opnås lækage i de to forseglede rum. Den magnetiske væske og digelstøtte vedtager en vandkølingstruktur for at sikre anvendeligheden med høj temperatur af magnetisk væske og digelstøtte og opnå stabiliteten af den termiske felttilstand.

2.3 Lavning af lavere dækningsløftningsmekanisme
Den nedre dækningsløftningsmekanisme består af en drivmotor, en kugleskrue, en lineær guide, en løftbeslag, et ovndæksel og et ovndækselbeslag. Motoren driver ovndæksletbeslaget tilsluttet skrueguideparret gennem en reducer for at realisere op- og nedbevægelsen af det nedre dæksel.
Den nedre dækningsløftningsmekanisme letter placeringen og fjernelse af store koribler i stor størrelse, og endnu vigtigere sikrer forseglingens pålidelighed af den nedre ovndæksel. Under hele processen har kammeret trykændringsstadier såsom vakuum, højt tryk og lavt tryk. Komprimerings- og tætningstilstanden for den nedre dækning påvirker direkte processen pålidelighed. Når tætningen mislykkes under høj temperatur, skrotes hele processen. Gennem motorens servokontrol og begrænsningsanordning kontrolleres tætheden i den nedre dækselenhed og kammeret for at opnå den bedste tilstand af komprimering og tætning af ovnkammerforseglingsringen for at sikre stabiliteten af procestrykket, som vist i figur 6.
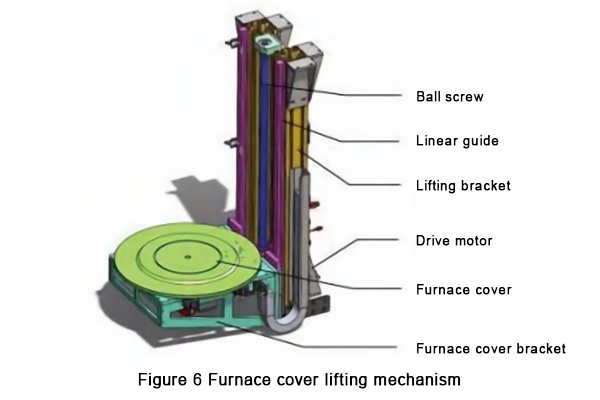
2.4 Elektrisk kontrolsystem
Under væksten af siliciumcarbidkrystaller skal det elektriske kontrolsystem nøjagtigt kontrollere forskellige procesparametre, hovedsageligt inklusive spolepositionshøjde, digelrotationshastighed, opvarmningseffekt og temperatur, forskellige specielle gasindtagsstrøm og åbningen af den proportionelle ventil.
Som vist i figur 7 bruger kontrolsystemet en programmerbar controller som en server, der er forbundet til Servo -driveren gennem bussen for at realisere bevægelseskontrollen af spolen og digelen; Det er forbundet til temperaturcontrolleren og flowcontroller gennem standard MobusRTU for at realisere realtidskontrol af temperatur, tryk og speciel procesgasstrøm. Det etablerer kommunikation med konfigurationssoftwaren gennem Ethernet, udveksler systeminformation i realtid og viser forskellige procesparameterinformation på værtscomputeren. Operatører, procespersonale og ledere udveksler information med kontrolsystemet gennem interface til human-maskine.

Kontrolsystemet udfører al feltdataindsamling, analyse af driftsstatus for alle aktuatorer og det logiske forhold mellem mekanismerne. Den programmerbare controller modtager instruktionerne fra værtscomputeren og afslutter styringen af hver aktuator af systemet. Udførelse og sikkerhedsstrategi for den automatiske procesmenu udføres alle af den programmerbare controller. Stabiliteten af den programmerbare controller sikrer stabiliteten og sikkerhedssikkerheden af procesmenuen.
Den øverste konfiguration opretholder dataudveksling med den programmerbare controller i realtid og viser feltdata. Det er udstyret med driftsgrænseflader, såsom opvarmningskontrol, trykstyring, gaskredsløbskontrol og motorisk kontrol, og indstillingsværdierne for forskellige parametre kan ændres på grænsefladen. Overvågning af alarmparametre i realtid, der giver skærmalarmdisplay, registrering af tiden og detaljerede data om alarmforekomst og gendannelse. Realtidsoptagelse af alle procesdata, skærmbetjeningsindhold og driftstid. Fusionskontrollen af forskellige procesparametre realiseres gennem den underliggende kode inde i den programmerbare controller, og maksimalt 100 trin af processen kan realiseres. Hvert trin inkluderer mere end et dusin procesparametre, såsom procesoperationstid, målkraft, måltryk, argonstrøm, nitrogenstrøm, brintstrøm, digelposition og digelfrekvens.
3 Termisk feltsimuleringsanalyse
Den termiske feltsimuleringsanalysemodel er etableret. Figur 8 er temperaturskyens kort i digelvækstkammeret. For at sikre væksttemperaturområdet for 4H-SIC enkeltkrystall beregnes midttemperaturen på frøkrystallen til at være 2200 ℃, og kanttemperaturen er 2205,4 ℃. På dette tidspunkt er den midterstemperatur på digeltoppen 2167,5 ℃, og den højeste temperatur i pulverområdet (side ned) er 2274,4 ℃, der danner en aksial temperaturgradient.

Den radiale gradientfordeling af krystallen er vist i figur 9. Den nedre laterale temperaturgradient af frøkrystalloverfladen kan effektivt forbedre krystalvækstformen. Den aktuelle beregnede initial temperaturforskel er 5,4 ℃, og den overordnede form er næsten flad og let konveks, som kan imødekomme den radiale temperaturstyringsnøjagtighed og ensartethedskrav i frøkrystalloverfladen.

Temperaturforskellekurven mellem råmaterialets overflade og frøkrystalloverfladen er vist i figur 10. Midtemperaturen på den materielle overflade er 2210 ℃, og en langsgående temperaturgradient på 1 ℃/cm dannes mellem den materielle overflade og frøkrystalloverfladen, som er inden for et rimeligt interval.
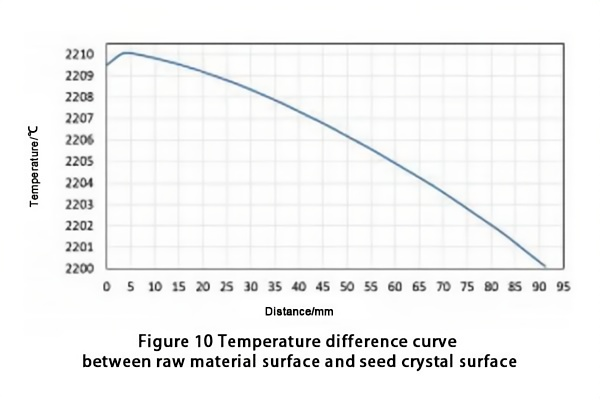
Den estimerede vækstrate er vist i figur 11. For hurtig vækst kan øge sandsynligheden for defekter, såsom polymorfisme og dislokation. Den nuværende estimerede vækstrate er tæt på 0,1 mm/t, hvilket er inden for et rimeligt interval.

Gennem termisk feltsimuleringsanalyse og beregning viser det sig, at midttemperaturen og kanttemperaturen for frøkrystallen opfylder den radiale temperaturgradient for krystallen på 8 tommer. På samme tid danner toppen og bunden af digelen en aksial temperaturgradient, der er egnet til krystallens længde og tykkelse. Den aktuelle opvarmningsmetode for vækstsystemet kan imødekomme væksten af 8-tommer enkeltkrystaller.
4 Eksperimentel test
Brug af dettesiliciumcarbid enkelt krystalvækstovn, baseret på temperaturgradienten for den termiske feltsimulering, ved at justere parametrene, såsom digelstemperaturen, hulrumstrykket, digelrotationshastigheden og den relative placering af den øverste og nedre spoler, blev der opnået en siliciumcarbidkrystallvæksttest, og en 8-tommer siliciumcarbidkrystal blev opnået (som vist i figur 12).

5 Konklusion
De vigtigste teknologier til vækst af 8-tommer siliciumcarbid enkeltkrystaller, såsom gradient termisk felt, digelbevægelsesmekanisme og automatisk kontrol af procesparametre, blev undersøgt. Det termiske felt i digelvækstkammeret blev simuleret og analyseret for at opnå den ideelle temperaturgradient. Efter testning kan dobbelt-coil-induktionsopvarmningsmetoden imødekomme væksten i stor størrelseSiliciumcarbidkrystaller. Forskningen og udviklingen af denne teknologi tilvejebringer udstyrsteknologi til opnåelse af 8-tommer carbidkrystaller og tilvejebringer udstyr til overgang af siliciumcarbidindustrialisering fra 6 tommer til 8 tommer, hvilket forbedrer væksteffektiviteten af siliciumcarbidmaterialer og reducerer omkostningerne.



+86-579-87223657


Wangda Road, Ziyang Street, Wuyi County, Jinhua City, Zhejiang-provinsen, Kina
Copyright © 2024 WuYi TianYao Advanced Material Tech.Co.,Ltd. Alle rettigheder forbeholdes.
Links | Sitemap | RSS | XML | Privatlivspolitik |
