QR kode

Produkter
Kontakt os


Fax
+86-579-87223657

E-mail

Adresse
Wangda Road, Ziyang Street, Wuyi County, Jinhua City, Zhejiang-provinsen, Kina
Siliciumcarbidsubstrater har mange defekter og kan ikke behandles direkte. En specifik enkelt krystal tynd film skal dyrkes på dem gennem en epitaksial proces for at fremstille chip -skiver. Denne tynde film er det epitaksiale lag. Næsten alle siliciumcarbidenheder realiseres på epitaksiale materialer. Siliciumcarbidhomogene epitaksiale materialer af høj kvalitet er grundlaget for udviklingen af siliciumcarbidindretninger. Udførelsen af epitaksiale materialer bestemmer direkte realiseringen af ydelsen af siliciumcarbidenheder.
Siliciumcarbidenheder med høj strøm og høj pålidelighed har fremsat strengere krav til overflademorfologi, defektdensitet, doping og tykkelse ensartethed af epitaksiale materialer. Storstørrelse, lav defekt densitet og høj ensartethedSiliciumcarbidepitaxyer blevet nøglen til udviklingen af siliciumcarbidindustrien.
Forberedelsen af høj kvalitetSiliciumcarbidepitaxyKræver avancerede processer og udstyr. Den mest anvendte siliciumcarbidepitaksiale vækstmetode er kemisk dampaflejring (CVD), som har fordelene ved præcis kontrol af epitaksial filmtykkelse og dopingkoncentration, færre defekter, moderat vækstrate og automatisk processtyring. Det er en pålidelig teknologi, der er blevet kommercialiseret med succes.
Siliciumcarbid CVD-epitaxy bruger generelt varm væg eller varmt væg CVD-udstyr, hvilket sikrer fortsættelse af det epitaksiale lag 4H-krystalsic under højere væksttemperaturforhold (1500-1700 ℃). Efter mange års udvikling kan varm væg eller varm væg CVD opdeles i vandrette vandrette strukturreaktorer og lodrette lodrette strukturreaktorer i henhold til forholdet mellem retningen af indgangsgasstrømmen og substratoverfladen.
Kvaliteten af siliciumcarbidepitaksialovn har hovedsageligt tre indikatorer. Den første er den epitaksiale vækstydelse, inklusive tykkelse ensartethed, dopinguniformitet, defekthastighed og væksthastighed; Den anden er temperaturens ydelse af selve udstyret, inklusive opvarmning/afkølingshastighed, maksimal temperatur, temperaturuniformitet; Og til sidst omkostningerne af selve udstyret, inklusive enhedspris og produktionskapacitet.
Varm væg vandret CVD, varm vægplanetarisk CVD og kvasi-hot væg lodret CVD er de almindelige epitaksiale udstyrsteknologiløsninger, der er blevet kommercielt anvendt på dette tidspunkt. De tre tekniske udstyr har også deres egne egenskaber og kan vælges efter behov. Strukturdiagrammet er vist på figuren nedenfor:

Det varme væghorisontale CVD-system er generelt et enkelt-vandre-vækstsystem i stor størrelse, der er drevet af luftflotation og rotation. Det er let at opnå gode indikatorer i Wafer. Den repræsentative model er PE1O6 for LPE Company i Italien. Denne maskine kan realisere automatisk belastning og losning af skiver ved 900 ℃. Hovedfunktionerne er en høj vækstrate, en kort epitaksial cyklus, god konsistens inden for skiven og mellem ovne osv. Den har den højeste markedsandel i Kina.

I henhold til LPE-officielle rapporter kombineret med brugen af større brugere, 100-150 mm (4-6 tommer) 4H-SIC-epitaksiale wafer-produkter med en tykkelse på mindre end 30μm produceret af Pe1O6-epitaksial ovn, kan stable opnå følgende indikatorer: intra-wafer epitaxial tykkelse ikke-uniformitet ≤2%, intra-wafer doping-koncentration ≤5%, overfladedefektdensitet ≤1 cm-2, overfladefejlfrit område (2 mm × 2 mm enhedscelle) ≥90%.
Indenlandske virksomheder som JSG, CETC 48, Naura og NASO har udviklet monolitisk siliciumcarbidepitaksialudstyr med lignende funktioner og har opnået store forsendelser. F.eks. I februar 2023 frigav JSG et 6-tommer dobbelt-værdigt SIC-epitaksialudstyr. Udstyret bruger de øvre og nedre lag af de øverste og nedre lag af grafitdele af reaktionskammeret til at dyrke to epitaksiale skiver i en enkelt ovn, og den øvre og nedre procesgasser kan reguleres separat, med en temperaturforskel på ≤5 ° C, hvilket effektivt udgør en del af utilstrækkelig produktionskapacitet af monolitisk horisontal epitaxial møbler. Den vigtigste del er en del af en del af den ujævnhedSic coating halfmoon dele.Vi leverer 6 tommer og 8 tommer halvmonedele til brugerne.

Det varme-væg-planetariske CVD-system med et planetarrangement af basen er kendetegnet ved væksten af flere skiver i en enkelt ovn og høj udgangseffektivitet. Repræsentative modeller er AIXG5WWC (8x150mm) og G10-SIC (9 × 150 mm eller 6 × 200 mm) epitaksialudstyr i Aixtron fra Tyskland.
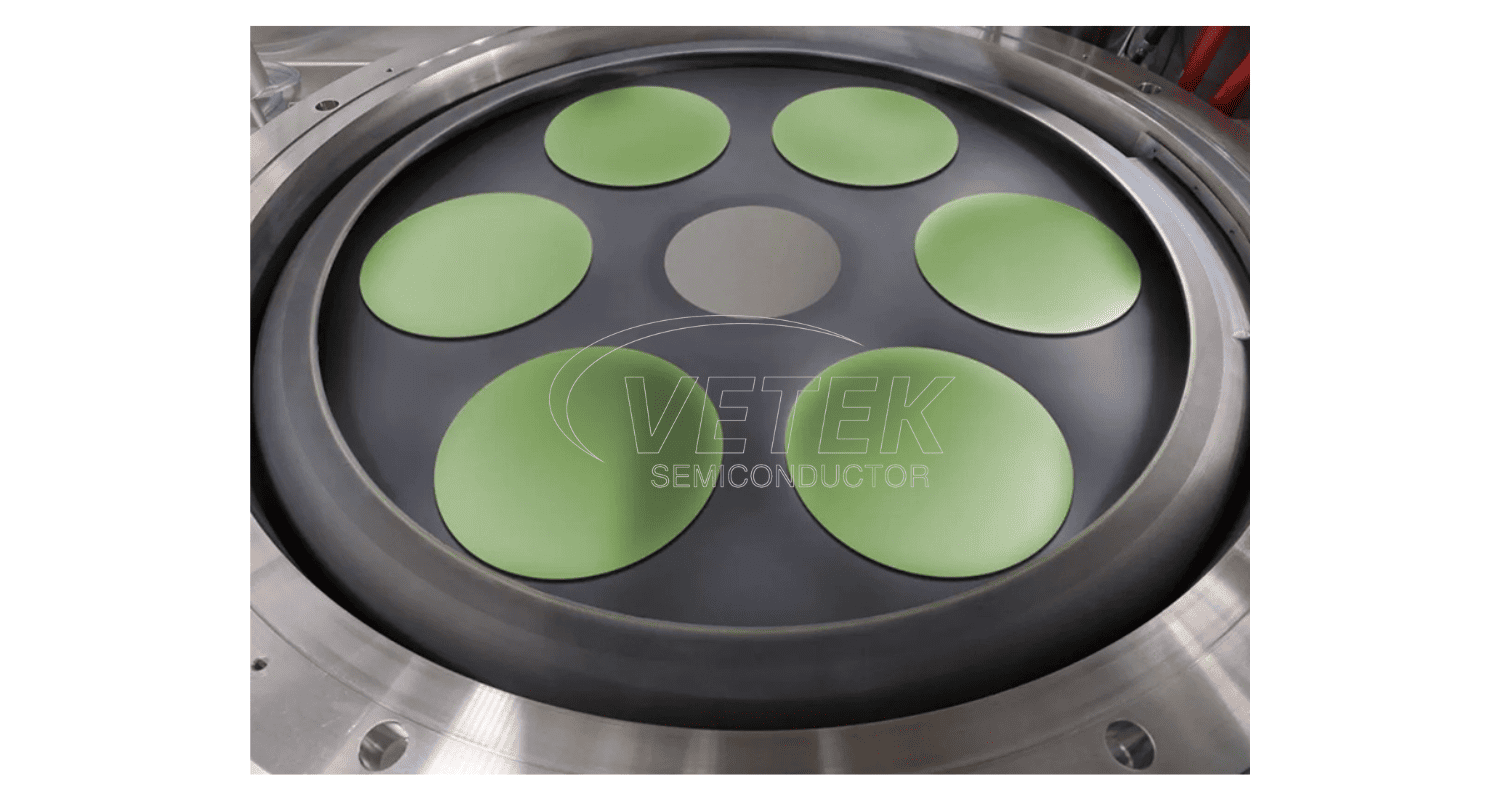
According to Aixtron's official report, the 6-inch 4H-SiC epitaxial wafer products with a thickness of 10μm produced by the G10 epitaxial furnace can stably achieve the following indicators: inter-wafer epitaxial thickness deviation of ±2.5%, intra-wafer epitaxial thickness non-uniformity of 2%, inter-wafer doping concentration deviation of ±5%, intra-wafer Dopingkoncentration Ikke-ensartethed <2%.
Indtil nu bruges denne type model sjældent af indenlandske brugere, og batchproduktionsdataene er utilstrækkelige, som til en vis grad begrænser sin tekniske anvendelse. På grund af de høje tekniske barrierer for epitaksiale ovne med flere værker med hensyn til temperaturfelt og flowfeltkontrol er udviklingen af lignende indenlandske udstyr stadig i forsknings- og udviklingsstadiet, og der er ingen alternativ model. I mellemtiden kan vi give Aixtron Planetary Sceptor som 6 tommer og 8 tommer med TAC-belægning eller SIC-belægning.
Det kvasi-hot-wall lodret CVD-system roterer hovedsageligt i høj hastighed gennem ekstern mekanisk hjælp. Dets kendetegn er, at tykkelsen af det viskøse lag effektivt reduceres ved et lavere reaktionskammertryk og derved øger den epitaksiale vækstrate. På samme tid har dens reaktionskammer ikke en øvre væg, hvorpå SIC -partikler kan deponeres, og det er ikke let at fremstille faldende genstande. Det har en iboende fordel ved defektkontrol. Repræsentative modeller er den enkeltvaskepitaksiale ovn Epirevos6 og Epirevos8 af Japans Nuflare.
I henhold til NuFlare kan vækstraten for EPIREVOS6-enheden nå mere end 50μm/t, og den epitaksiale skive kan kontrolleres under 0,1 cm-²; Med hensyn til ensartethedskontrol rapporterede NUFLARE-ingeniør Yoshiaki Daigo, at de intra-wafer-ensartethedsresultater af en 10μm tyk 6-tommer epitaksial wafer dyrket ved hjælp af Epirevos6, og den intra-wafer tykkelse og dopingkoncentrations-ikke-ensartethed nåede henholdsvis 1% og 2,6%. Vi giver Sic Coated High Purity-dele dele som lignende del af den lignende del af ligen som en del af den doping-del som som-lignende dele som ligesom-lignende dele som ligesom-lignende dele som ligesom som-lignende del-lignende del af den delte del af høje puritetsdele som en puritetsdele som en puritetsgrafik som dopering af høj puritetsdele som en puritetsgrafik som doping af høj puritetsgrafik som Doping-dele som en puritetsgrafik som Doping-dele som Doping-dele som Doping-dele som Doping Koncentration.Øvre grafitcylinder.
På nuværende tidspunkt har indenlandske udstyrsproducenter som Core Third Generation og JSG designet og lanceret epitaksialudstyr med lignende funktioner, men de er ikke blevet brugt i stor skala.
Generelt har de tre typer udstyr deres egne egenskaber og besætter en bestemt markedsandel i forskellige applikationsbehov:
Den varme væghorisontale CVD-struktur har ultrahurtige vækstrate, kvalitet og ensartethed, enkel udstyrsdrift og vedligeholdelse og modne store produktionsapplikationer. På grund af den enkeltvasketype og hyppig vedligeholdelse er produktionseffektiviteten imidlertid lav; Den varme vægplanetariske CVD vedtager generelt en 6 (stykke) × 100 mm (4 tommer) eller 8 (stykke) × 150 mm (6 tommer) bakkestruktur, hvilket i høj grad forbedrer produktionseffektiviteten af udstyret med hensyn til produktionskapacitet, men det er vanskeligt at kontrollere konsistensen af flere stykker, og produktionsudbyttet er stadig det største problem; Den kvasi-hot væg-lodret CVD har en kompleks struktur, og kvalitetsdefektkontrollen af den epitaksiale skiveproduktion er fremragende, hvilket kræver ekstremt rig udstyrs vedligeholdelse og brugsoplevelse.
Hurtig vækstrate
enkel udstyrsstruktur og
praktisk vedligeholdelse
Stor produktionskapacitet
høj produktionseffektivitet
God produkt defekt kontrol
Lang reaktionskammer
Vedligeholdelsescyklus
Kompleks struktur
vanskeligt at kontrollere
Produktkonsistens
Kompleks udstyrsstruktur,
vanskelig vedligeholdelse
Repræsentant
udstyr
Producenter
Varm væg vandret CVD
Varm vægplanetarisk CWD
Kvasi-hot væg lodret ctd
Fordele
Ulemper
Kort vedligeholdelsescyklus
Italien LPE, Japan Tlf
Tyskland Aixtron
Japan Nuflare
Med den kontinuerlige udvikling af industrien vil disse tre typer udstyr iterativt optimeres og opgraderes med hensyn til struktur, og udstyrskonfigurationen vil blive mere og mere perfekt, hvilket spiller en vigtig rolle i at matche specifikationerne for epitaksiale skiver med forskellige tykkelser og mangelkrav.



+86-579-87223657


Wangda Road, Ziyang Street, Wuyi County, Jinhua City, Zhejiang-provinsen, Kina
Copyright © 2024 WuYi TianYao Advanced Material Tech.Co.,Ltd. Alle rettigheder forbeholdes.
Links | Sitemap | RSS | XML | Privatlivspolitik |
