QR kode

Produkter
Kontakt os


Fax
+86-579-87223657

E-mail

Adresse
Wangda Road, Ziyang Street, Wuyi County, Jinhua City, Zhejiang-provinsen, Kina
Kemisk mekanisk polering (CMP) fjerner overskydende materiale- og overfladefejl gennem den kombinerede virkning af kemiske reaktioner og mekanisk slid. Det er en nøgleproces til at opnå global planarisering af waferoverfladen og er uundværlig for flerlags kobberforbindelser og lav-k dielektriske strukturer. I praktisk fremstilling er CMP ikke en perfekt ensartet fjernelsesproces; det giver anledning til typiske mønsterafhængige defekter, blandt hvilke dishing og erosion er de mest fremtrædende. Disse defekter påvirker direkte sammenkoblingslagenes geometri og deres elektriske egenskaber.
Dishing refererer til overdreven fjernelse af relativt bløde ledende materialer (såsom kobber) under CMP, hvilket fører til en skålformet konkav profil inde i en enkelt metallinje eller et stort metalområde. I tværsnit ligger midten af metallinjen lavere end dens to kanter og den omgivende dielektriske overflade. Dette fænomen observeres ofte i brede linjer, puder eller metalområder af bloktype. Dens dannelsesmekanisme er hovedsageligt relateret til forskelle i materialehårdhed og deformation af polerpuden over brede metalelementer: Bløde metaller er mere følsomme over for de kemiske komponenter og slibemidler i gyllen, og det lokale kontakttryk af puden stiger på brede træk, hvilket får fjernelseshastigheden i midten af metallet til at overstige det ved kanterne. Som et resultat heraf øges dybden af opvasken sædvanligvis med linjebredden og overpoleringstiden.
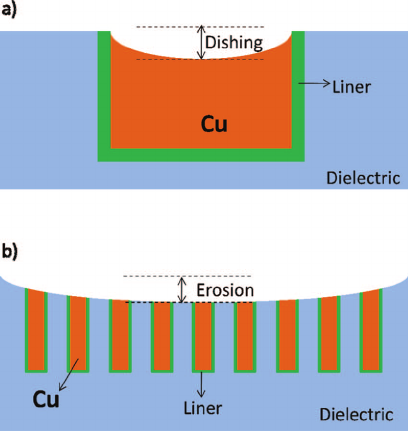
Erosion er kendetegnet ved, at den samlede overfladehøjde i områder med høj mønstertæthed (såsom tætte metallinjearrays eller områder med tæt dummyfyld) er lavere end i omgivende sparsomme områder efter CMP. I bund og grund er det en mønsterdensitetsdrevet overfjernelse af materiale på regionsniveau. I tætte områder giver metal og dielektrikum tilsammen et større effektivt kontaktareal, og den mekaniske friktion og kemiske virkning af puden og opslæmningen er stærkere. Som følge heraf er de gennemsnitlige fjernelseshastigheder af både metal og dielektrikum højere end i områder med lav tæthed. Efterhånden som polering og overpolering skrider frem, bliver den metal-dielektriske stak i tætte områder tyndere som helhed og danner et målbart højdetrin, og graden af erosion stiger med lokal mønstertæthed og procesbelastning.
Ud fra enhedens og procesydelsens perspektiv har dishing og erosion adskillige negative indvirkninger på halvlederprodukter. Dishing reducerer det effektive tværsnitsareal af metallet, hvilket fører til højere sammenkoblingsmodstand og IR-fald, hvilket igen forårsager signalforsinkelse og reduceret timingmargin på kritiske veje. Variationer i dielektrisk tykkelse forårsaget af erosion ændrer den parasitære kapacitans mellem metallinjer og fordelingen af RC-forsinkelse, hvilket underminerer ensartetheden af elektriske egenskaber på tværs af chippen. Derudover påvirker lokal dielektrisk udtynding og elektrisk feltkoncentration nedbrydningsadfærden og langsigtet pålidelighed af intermetal-dielektriske stoffer. På integrationsniveauet øger overdreven overfladetopografi vanskeligheden med litografisk fokus og justering, forringer ensartetheden af efterfølgende filmaflejring og ætsning og kan inducere defekter såsom metalrester. Disse problemer manifesterer sig i sidste ende som udsving i udbyttet og et faldende procesvindue. Derfor er det i praktisk ingeniørarbejde nødvendigt at kontrollere udvaskning og erosion inden for specificerede grænser gennem layout-densitetsudligning, optimering afpolering slurerselektivitet og finjustering af CMP-procesparametre for at sikre planariteten af sammenkoblingsstrukturer, stabil elektrisk ydeevne og robust højvolumenproduktion.



+86-579-87223657


Wangda Road, Ziyang Street, Wuyi County, Jinhua City, Zhejiang-provinsen, Kina
Copyright © 2024 WuYi TianYao Advanced Material Tech.Co.,Ltd. Alle rettigheder forbeholdes.
Links | Sitemap | RSS | XML | Privatlivspolitik |
