QR kode

Produkter
Kontakt os


Fax
+86-579-87223657

E-mail

Adresse
Wangda Road, Ziyang Street, Wuyi County, Jinhua City, Zhejiang-provinsen, Kina
ÆtsningTeknologi er et af de vigtigste trin i halvlederproduktionsprocessen, der bruges til at fjerne specifikke materialer fra skiven til at danne et kredsløbsmønster. Under den tørre ætsningsproces støder imidlertid ingeniører ofte på problemer, såsom belastningseffekt, mikro-rilleffekt og opladningseffekt, som direkte påvirker kvaliteten og ydeevnen for det endelige produkt.
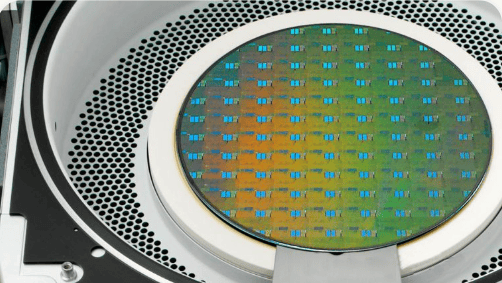
Lastningseffekten henviser til det fænomen, at når ætsningsområdet øges, eller ætsningsdybden øges under tør ætsning, falder ætsningshastigheden, eller ætsningen er ujævn på grund af utilstrækkelig tilførsel af reaktiv plasma. Denne virkning er normalt relateret til egenskaberne ved ætsningssystemet, såsom plasmatæthed og ensartethed, vakuumgrad osv., Og er bredt til stede i forskellige reaktive ionetching.
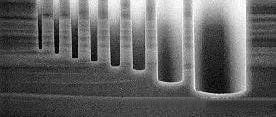
•Forbedre plasmadensitet og ensartethed: Ved at optimere designet af plasmakilden, såsom at bruge mere effektiv RF -effekt eller magnetron -sputtering -teknologi, kan der genereres en højere densitet og mere ensartet distribueret plasma.
•Juster sammensætningen af den reaktive gas: Tilføjelse af en passende mængde hjælpegas til den reaktive gas kan forbedre plasmaets ensartethed og fremme den effektive udledning af ætsningsbiprodukter.
•Optimer vakuumsystemet: Forbedring af pumpehastigheden og effektiviteten af vakuumpumpen kan hjælpe med at reducere opholdstiden for ætsningsbiprodukter i kammeret og derved reducere belastningseffekten.
•Design et rimeligt fotolitografisk layout: Ved design af fotolitografilayoutet bør tætheden af mønsteret tages i betragtning for at undgå overtæt arrangement i lokale områder for at reducere påvirkningen af belastningseffekten.
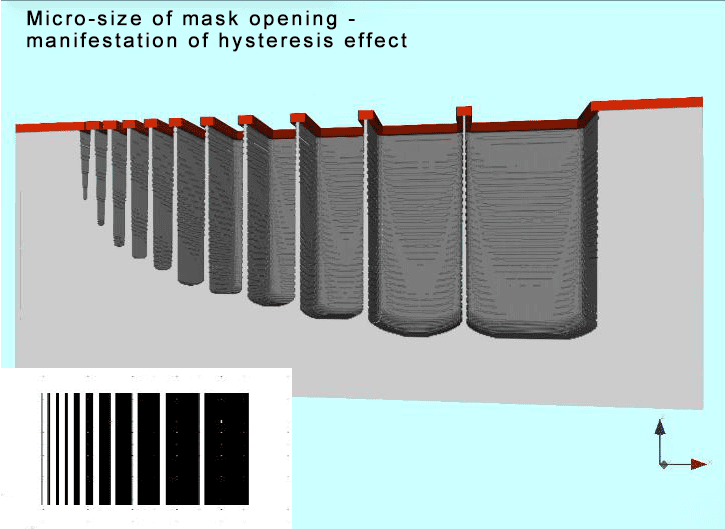
Den mikro-grøfteffekt henviser til det fænomen, der under ætsningsprocessen på grund af de højenergipartikler, der rammer ætsningsoverfladen i en skrå vinkel, er ætsningshastigheden nær sidevæggen højere end i det centrale område, hvilket resulterer i ikke -Vertiske affyrer på sidevæggen. Dette fænomen er tæt knyttet til vinklen på hændelsespartiklerne og hældningen af sidevæggen.
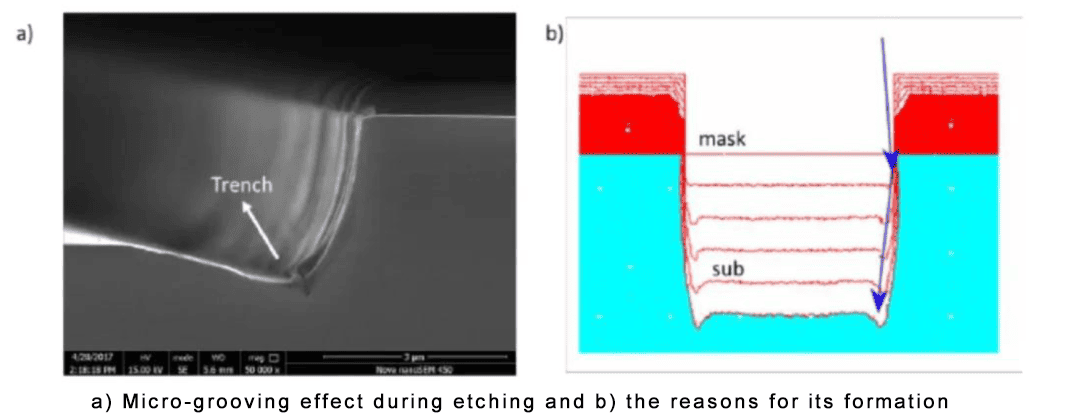
•Forøg RF -strøm: Korrekt forøgelse af RF -effekten kan øge energien fra hændelsespartiklerne, hvilket giver dem mulighed for at bombardere måloverfladen mere lodret og derved reducere ætsningshastighedsforskellen på sidevæggen.
•Vælg det rigtige ætsningsmaskemateriale: Nogle materialer kan bedre modstå opladningseffekten og reducere mikro-grøfteffekten forværret ved ophobning af negativ ladning på masken.
•Optimer ætsningsbetingelser: Ved at finjustere parametre, såsom temperatur og tryk under ætsningsprocessen, kan selektiviteten og ensartetheden af ætsning kontrolleres effektivt.
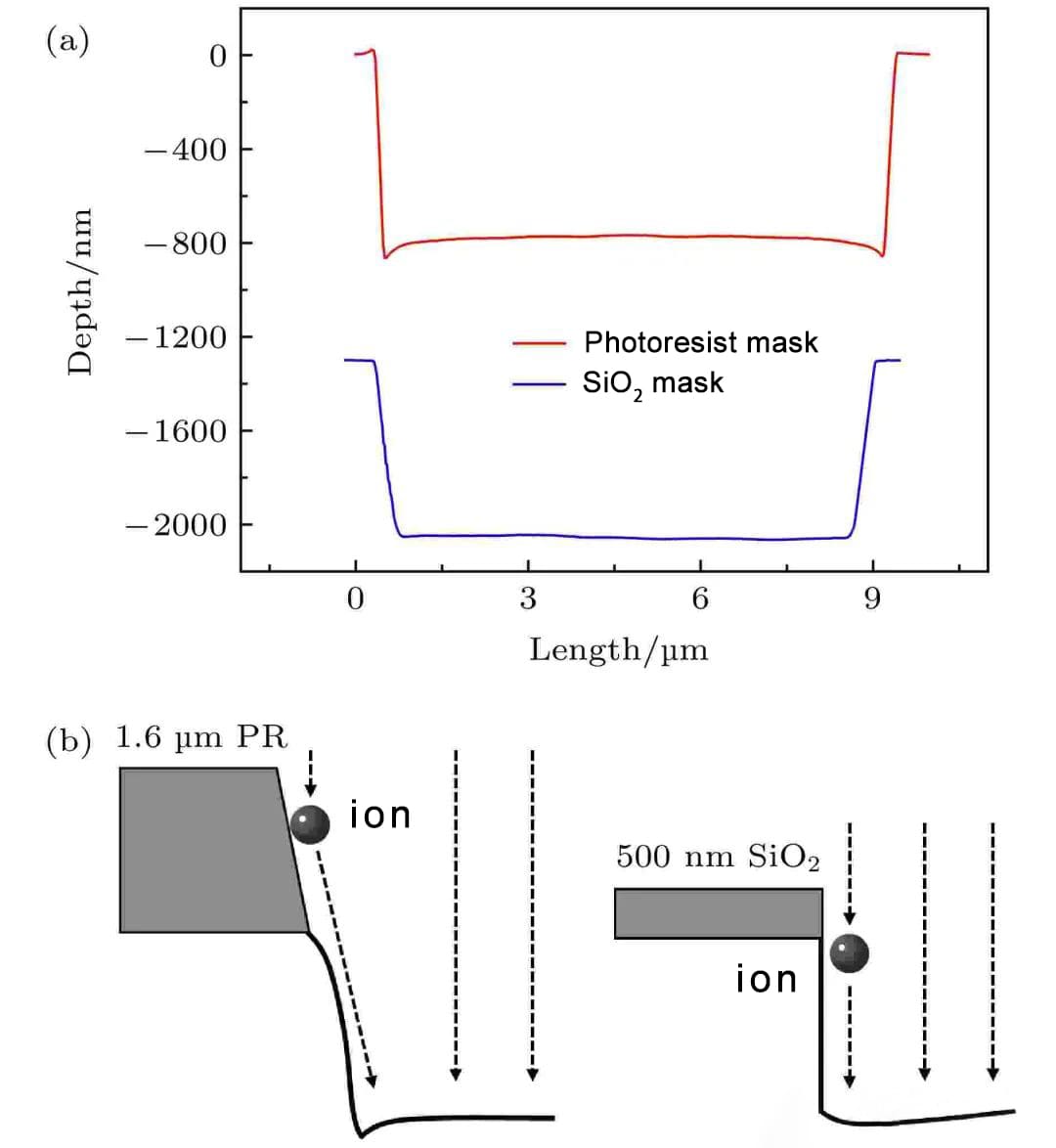
Opladningseffekten er forårsaget af de isolerende egenskaber af ætsemasken. Når elektronerne i plasmaet ikke kan undslippe hurtigt, samles de på maskeoverfladen for at danne et lokalt elektrisk felt, forstyrre stien til hændelsespartiklerne og påvirke anisotropien af ætsning, især når det er ætsning af fine strukturer.
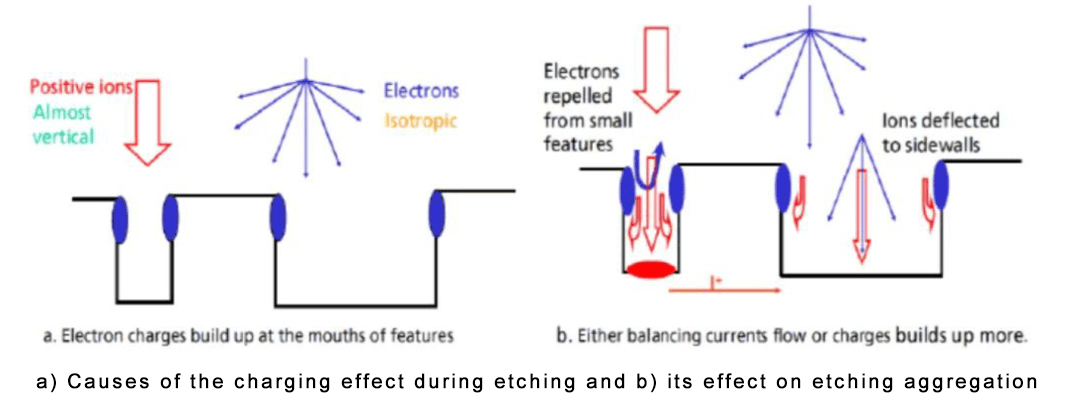
• Vælg passende ætsningsmaskematerialer: Nogle specielt behandlede materialer eller ledende maskelag kan effektivt reducere aggregeringen af elektroner.
•Implementere intermitterende ætsning: Ved periodisk at afbryde ætseprocessen og give elektroner tilstrækkelig tid til at undslippe, kan opladningseffekten reduceres betydeligt.
•Juster ætsningsmiljøet: Ændring af gassammensætning, tryk og andre forhold i ætsemiljøet kan hjælpe med at forbedre stabiliteten af plasmaet og reducere forekomsten af opladningseffekten.
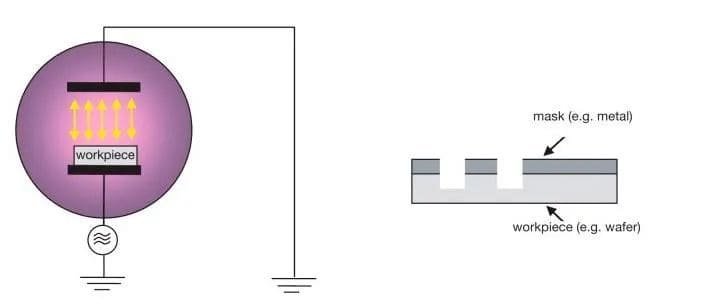



+86-579-87223657


Wangda Road, Ziyang Street, Wuyi County, Jinhua City, Zhejiang-provinsen, Kina
Copyright © 2024 WuYi TianYao Advanced Material Tech.Co.,Ltd. Alle rettigheder forbeholdes.
Links | Sitemap | RSS | XML | Privatlivspolitik |
